- HOME
- 【注目】 AI時代の発展を支える半導体製造技術 「ハイブリッドボンディング」とは
生産現場 計測・検査
【注目】 AI時代の発展を支える半導体製造技術
「ハイブリッドボンディング」とは
先端半導体の技術の中でも微細化と並んで今後の半導体性能を大きく左右する、3次元実装技術。その構成技術であるハイブリッドボンディングについて解説します。
半導体製造現場の課題を解決!厳選ホワイトペーパー4選(無料)
ハイブリッドボンディングとは
ハイブリッドボンディングは、半導体パッケージング技術の一つで、2つ以上の半導体デバイス(一般的には集積回路(IC))のメタルパッド*¹ をCuバンプ*² などを介さずに直接接続するものです。そのため、パンプの径による空間の制約を受けずにより多くのインターコネクト(相互接続)*³ が可能となります。
ハイブリッドボンディングはインターコネクトの接続ピッチが10um以下の場合に使用されます。
ハイブリッドボンディング技術採用の拡大背景としては、HPC(ハイパフォーマンスコンピューティング)などに使用される最先端半導体デバイスでの演算処理能力の向上とそれにともなうインターコネクトの増加があります。最先端の半導体プロセッサーでは、シミュレーション、データ処理など、複雑で計算量の多いタスクを処理するように設計されています。そのため、要求される性能を達成するために、大量のデータを迅速かつ効率的に処理・転送する必要があります。
プロセッサー、メモリー、アクセラレーターなど、さまざまなコンポーネント間で高速なデータ転送と通信をする必要が生じるため、より高密度なインターコネクトが必要となります。
ハイブリッドボンディングは、従来のワイヤーボンディングやフリップチップ技術と比較して、前述のように高密度なインターコネクトが可能であり、また垂直に接続することにより配線距離が短くなるので、電気的性能の向上、消費電力の削減、通信遅延の低減等効果も見込まれます。そのため、デバイスの性能向上にともなう課題の対策として、HPCやHBM(High band width memory)*⁴ 向けで採用が進んでいます。
チップ接続方式とバンプサイズの比較
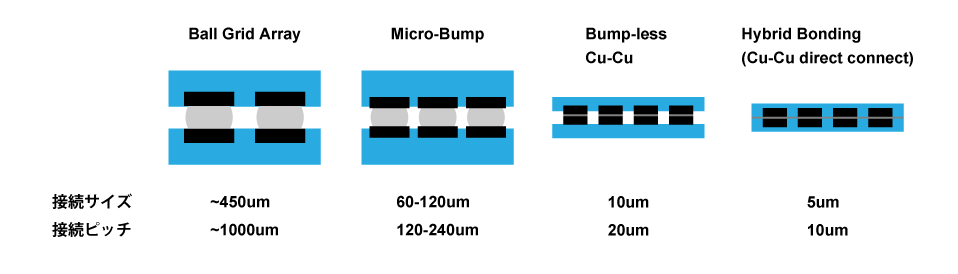
2.5次元集積のハイブリッドボンディング使用部位(側面側)
![]()
ハイブリッドボンディング積層プロセス
現在半導体デバイスをハイブリッドボンディングを用いて積層する場合には2つの方式が主に採用されています。1つはW2Wと呼ばれる半導体デバイスをトップ側、ボトム側ともウェーハ状態で積層する方式ともう一つはD2Wと呼ばれる半導体デバイスをトップ側をダイにスライスしたうえで、ボトム側のウェーハに積層する方式です。
各方式にはそれぞれ特徴があります。
W2Wは一括で積層するので、生産性はD2Wより優れていますが、良品チップを選別していないため歩留まりは劣っています。D2Wは逆に生産性は1個ずつチップをピックするため、W2Wより劣っていますが、歩留まりは良品チップを選別して積層するために、優れています。それぞれの方式の長所をとって、ウェーハ上に良品チップをピックアップしたあとに、ウェーハとウェーハを貼り合わせ積層する方式も検討されています。
W2WとD2W方式のイメージ図
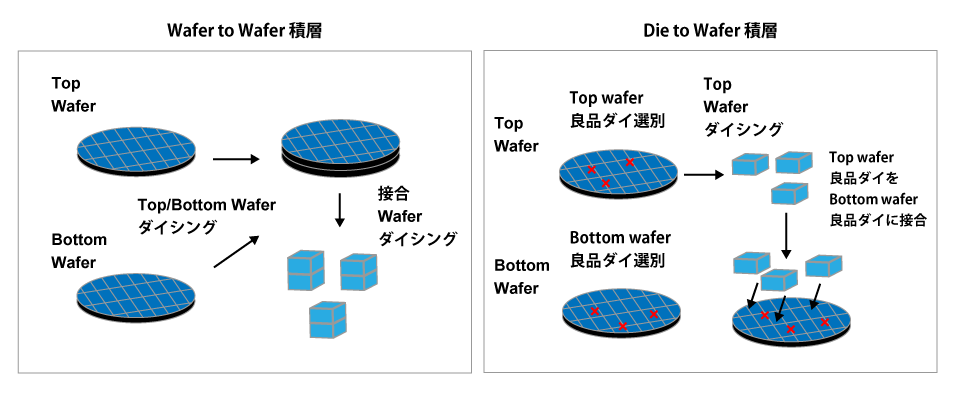
ハイブリッドボンディング接合プロセス
ハイブリッドボンディング接合プロセスは、金属と誘電体材料*⁵ の組み合わせで2枚の半導体ウェーハやダイを接合します。一般的に、電気配線の金属として銅(Cu)が使用され、絶縁のために二酸化ケイ素(SiO2)や窒化ケイ素(SiN)などの誘電体材料が使用されます。
適切な接合を行うための工程
・表面処理を行う
半導体ウェハーやダイを洗浄し、金属と誘電体材料が適切に接着し電気的に接触するように準備します。CMP(化学的機械的平坦化)や特殊な化学薬品を使った洗浄などの工程が含まれます。
・アライメントとボンディング
ウェハーまたはダイは、2つの表面の金属相互接続が適切に接触するように、通常、専用装置を使用して極めて正確に位置合わせされます。アライメント後、ウェハーまたはダイを近づけ、温度、圧力、場合によっては電界を加えて、金属と誘電体材料の間に強力な化学的・機械的結合を形成します。
・ポストボンドアニーリング
ボンドをさらに強化し、ハイブリッドボンディングの全体的な信頼性を向上させるために、ボンド後のアニール(熱処理)工程を行います。このステップでは、通常、接合されたウェーハまたはダイを特定の温度で規定時間加熱します。
・シンギュレーションとパッケージング
接合工程の後、接合されたウェハーまたはダイは、個々のICをウェハーから切り離すシングレーションを行います。最後に、ICが正常に機能するようにパッケージングされ、テスト出荷されます。
ハイブリッドボンディング接合接合プロセスイメージ
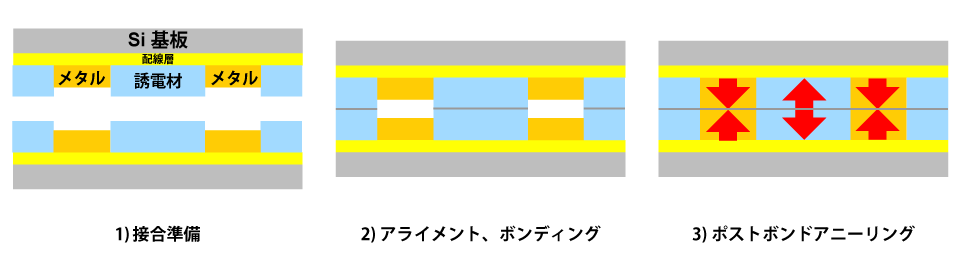
ハイブリッドボンディングの課題
ハイブリッドボンディングは量産開始がされてからまだ比較的新しい技術であり、まだ解決が必要ないくつかの課題と直面しています。具体的には、精密な位置合わせ、表面処理と清浄度、プロセス制御と歩留まり、接合強度と信頼性、熱機械的応力管理、試験性と修理性、コストなどがあげられます。
これらの課題を解決するためには、プロセス制御、材料、装置における継続的な革新と開発により、ハイブリッド接合の性能、信頼性、費用対効果をさらに向上させることが必要です。
以上のような課題がありますが、ハイブリッドボンディングは、相互接続密度、性能、フォームファクター*⁵ 削減の利点から、次世代の半導体デバイスを支える重要な技術として、より幅広いアプリケーションや産業への応用が期待されています。
半導体製造現場の課題を解決!厳選ホワイトペーパー
半導体製造現場の「検査」「監視・調査」「セキュリティ」について、例を挙げて解説しています。日々の業務に是非ご活用ください。
半導体は次の次元へ 微細化から集積へ アドバンストパッケージの世界
【この資料で分かること】
- 市場と技術の未来
- アドバンストパッケージの進化
- ウェーハ加工の課題解決
【こんな方におすすめ】
半導体市場やアドバンストパッケージ技術の動向を把握したい方、製造工程やウェーハ加工における課題解決を求めている方、高速化・高密度化を実現する製造技術に興味がある方、次世代半導体の開発に関わる技術者やエンジニアの方

半導体ウェーハの外観検査まるわかりブック
【この資料で分かること】
- 多様なウェーハ材料
- ウェーハ製造工程と外観検査
- 欠陥の種類
- 検査技術のカテゴリ
【こんな方におすすめ】
Siウェーハ、化合物ウェーハ(SiC, GaN, LT/LN, InP), ガラスウェーハ等の検査に関心や課題をお持ちの方

半導体工場の現場DXガイドブック -設備の予知保全、品質監視-
【この資料で分かること】
- 半導体製造工程とDXの取組み
- 製造プロセス監視の作業自動化
- ウェーハ欠陥の原因調査
- 設備稼働監視作業の自動化
- 装置・設備・部品の故障予兆監視
【こんな方におすすめ】
ウェーハ製造工場や、デバイス製造工場のファシリティ設備の業務課題に関心や課題をお持ちの方

OTを止めるな!!半導体業界に必須のサイバー攻撃対策
【この資料で分かること】
- 外部脅威を排除しセキュアな工場へ
- 内部関係者によるリスク対策
- サプライチェーンリスク
- 横感染
- リスク発生&対策ソリューションマップ
【こんな方におすすめ】
半導体製造工場の現場、IT担当者、半導体装置メーカーでセキュリティに関心と課題をお持ちの方

用語集
*¹ メタルパッド
メタルパッドとは、電気的接続を可能にするためのチップ上の小さな金属領域を指します。これらのパッドはアルミニウムや銅などの金属で作られ、ボンディングワイヤーやフリップチップバンプが取り付けられ、外部への電気的接続を確立します。
*² Cuバンプ
Cu バンプ(銅バンプ)とは、フリップチップパッケージングに使用される銅製のバンプを指します。チップがこれらの導電性バンプを用いて基板に直接接続されます。銅は電気的および熱的な特性が優れており、デバイスの性能を向上させます。
*³ インターコネクト
インターコネクトとは、半導体デバイス内の各コンポーネント間の電気的接続を提供する金属配線または導体のシステムを指します。これらの配線は、トランジスタ、ダイオード、レジスタなどのアクティブデバイスやパッシブコンポーネントを接続し、集積回路の全体的な機能を実現します。
*⁴ HBM(High band width memory)
HBM(High Bandwidth Memory)とは、高帯域幅と低エネルギー消費を実現する新型のDRAMです。3D積層メモリチップを使用し、スルーシリコンビア(TSV)技術でチップ間を直接接続します。HBMは、高性能コンピューティングやゲーミングなどで使用されています。
*⁵ 誘電体材料
誘電材料とは、電気を通さず電場を保存する素材で、半導体デバイス内の電荷の移動を制御します。例えば、モスフィールド効果トランジスタでは、ゲートと半導体チャネル間の絶縁体として誘電材料が使用されます。
*⁶ フォームファクター
フォームファクターとは、半導体デバイスの物理的な形状、サイズ、そしてそれが占める空間や必要な電力、発生する熱などの特性を指します。
























