- HOME
- 【注目】 AI時代の発展を支える半導体製造技術 「BSPDN(Backside Power Delivery Network)」とは
生産現場 計測・検査
【注目】 AI時代の発展を支える半導体製造技術
「BSPDN(Backside Power Delivery Network)」とは
先端半導体の技術の中でも微細化と並んで今後の半導体性能を大きく左右する、3次元実装技術。その構成技術であるBSPDN(Backside Power Delivery Network)について解説します。
半導体製造現場の課題を解決!厳選ホワイトペーパー4選(無料)
BSPDN(Backside Power Delivery Network)とは
BSPDN(Backside Power Delivery Network)とは、裏面電源供給ネットワークの略称で、半導体チップの電源供給効率を向上させるための半導体技術です。
従来トランジスタの上層にあった電源供給ネットワーク全体をシリコンウェハの裏面側に移動させることで、電源供給ネットワークと信号ネットワークを分離するというものです。
これにより、電源供給の効率が向上し、異なるネットワーク間の干渉が減少します
実施プロセスとしては、まず BPR(Buried Power Rail)*¹ と呼ばれる技術で、電源線と接地線をトランジスタ下部に埋め込みます。その後BPR裏面にBSPDNを形成しBPRに電力を供給し、そこからトランジスタへの電力を供給します。 BSPDNとBPR間は垂直方向のViaで電力供給を行います。
BPRとBSPDNを組み合わせることにより、トランジスタへ最短距離での電力供給が可能となり、電力伝達の効率が向上し、チップ全体の性能に寄与します。電源供給ネットワークと信号ネットワークの分離により、両者間の干渉を大幅に減少させ、信号の品質向上に貢献します。
また、従来は使用されていなかったウェハの裏面を活用することで、より多くのトランジスタや回路をフロントサイドに集積、より小型で高性能な半導体デバイスの設計が可能になります。
BSPDN採用の背景
BSPDN採用の背景としては、ムーアの法則*² による微細化の進展によりトランジスタ上層部からの安定した電源供給が難しくなってきていることへの対応があげられます。
具体的には、微細化が進展するにつれて、同一面積内におけるトランジスタの数が増えていきます。その結果トランジスタ間をつなぐ配線の積重ね総数が増え、電源供給部位からトランジスタへの距離が離れてしまい、IRドロップ*³ など不具合の原因となっています。配線距離が長くなることで、配線抵抗が増え、発熱の要因にもなります。
また、従来からの表面電源供給だと、信号供給ネットワークと電源供給ネットワークは同一空間に存在するため混線原因となり信号遅延等システムに悪影響を及ぼす可能性があります。
さらに、設置スペースの問題もあります。電源供給ネットワークは信号ネットワークと比べて配線幅が広いため、同一空間上で大きなスペースを占めており、ムーアの法則進展による、信号線微細化によるシステム縮小の恩恵を生かせていない課題があります。
BSPDNは従来の電源供給方式の限界を打破し、高性能、低消費電力を実現する技術として期待されています。
BSPDNの課題と展望
半導体デバイス機能向上にさまざまなメリットのあるBSPDNですが、従来とは異なる設計、製造工程が必要となります。具体的には、BPR形成後にBSPDNと接続するために形成するナノTSV技術があります。
現在Siインターポーザー等で仕様されているTSVの径が約10umであるのに対し、ナノTSVは100nmほどの径で非常に微細な加工が必要となります。TSVを形成するSiは薄化に対するサポートのため別基板貼り合わせが必要で、その後の薄化工程で775um厚みから数百nmレベルへの薄化が必要となります。
また同様の面内均一性が求められます。薄化に際して、研削、エッチング、CMPとさまざまな薄化工程を組み合わせる必要が生じます。また薄化後にはBEOL工程*⁴ での配線層の形成が必要となります。
このように従来前工程ではあまり使用されてこなかった研削、貼り合わせプロセスと従来の配線形成前工程プロセスを連続的に実施する必要が生まれ、ここに新たな技術的課題が生じています。
しかしながらこれらの課題は、半導体業界における新たな技術的進展とイノベーションを促進し、新しいアプリケーションや市場の機会が生まれる契機ともなります。BSPDNは半導体技術において重要な進歩を表しており、その実装にはいくつかの課題が伴いますが、それによってもたらされる利点と潜在能力は計り知れないものです。
例えば、BSPDNが使用されるデバイスとしてはAIに代表される、高性能コンピューターシステムやサーバー向けデバイスへの導入が検討されています。これらのデバイスは計算能力を最大化しながら電力消費を抑える必要があるためです。
BSPDNの導入は、これらの技術的および市場の要求に応えるための重要なステップとなっており、半導体デバイスの性能向上と電力効率の改善に大きく寄与すると期待されています。
従来構造とBSPDNの比較イメージ(断面図)
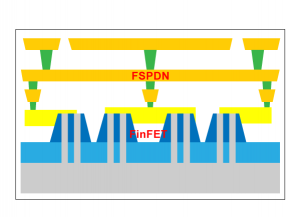 FSPDN(表面電源供給)従来方式
FSPDN(表面電源供給)従来方式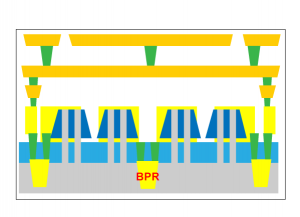 BPR+FSPDN(表面電源供給)
BPR+FSPDN(表面電源供給)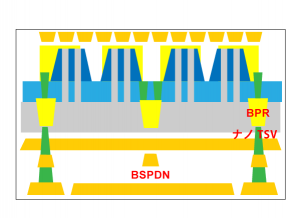 BPR+BSPDN(裏面電源供給)
BPR+BSPDN(裏面電源供給)
半導体製造現場の課題を解決!厳選ホワイトペーパー
半導体製造現場の「検査」「監視・調査」「セキュリティ」について、例を挙げて解説しています。日々の業務に是非ご活用ください。
半導体は次の次元へ 微細化から集積へ アドバンストパッケージの世界
【この資料で分かること】
- 市場と技術の未来
- アドバンストパッケージの進化
- ウェーハ加工の課題解決
【こんな方におすすめ】
半導体市場やアドバンストパッケージ技術の動向を把握したい方、製造工程やウェーハ加工における課題解決を求めている方、高速化・高密度化を実現する製造技術に興味がある方、次世代半導体の開発に関わる技術者やエンジニアの方

半導体ウェーハの外観検査まるわかりブック
【この資料で分かること】
- 多様なウェーハ材料
- ウェーハ製造工程と外観検査
- 欠陥の種類
- 検査技術のカテゴリ
【こんな方におすすめ】
Siウェーハ、化合物ウェーハ(SiC, GaN, LT/LN, InP), ガラスウェーハ等の検査に関心や課題をお持ちの方

半導体工場の現場DXガイドブック -設備の予知保全、品質監視-
【この資料で分かること】
- 半導体製造工程とDXの取組み
- 製造プロセス監視の作業自動化
- ウェーハ欠陥の原因調査
- 設備稼働監視作業の自動化
- 装置・設備・部品の故障予兆監視
【こんな方におすすめ】
ウェーハ製造工場や、デバイス製造工場のファシリティ設備の業務課題に関心や課題をお持ちの方

OTを止めるな!!半導体業界に必須のサイバー攻撃対策
【この資料で分かること】
- 外部脅威を排除しセキュアな工場へ
- 内部関係者によるリスク対策
- サプライチェーンリスク
- 横感染
- リスク発生&対策ソリューションマップ
【こんな方におすすめ】
半導体製造工場の現場、IT担当者、半導体装置メーカーでセキュリティに関心と課題をお持ちの方

- *¹ BPR(Buried Power Rail)
- BPR(Buried Power Rail、埋め込み電源レール)とは、従来トランジスタの表側に配置されていた電源レールをトランジスタ背面に設置する製造技術です。
- *² ムーアの法則
- ムーアの法則とは、半導体の集積回路上のトランジスタ数が約2年ごとに倍増するという観測に基づく予測です。
- *³ IRドロップ
- IRドロップとは、電流が抵抗を流れる際に生じる電圧降下を指します。
- *⁴ BEOL工程
- BEOL工程は、半導体製造の後半段階で、回路配線、絶縁層、および他の相互接続を形成するプロセスです。


























