製品・サービス
Si ウェーハ 欠陥検査装置
光の僅かな変化を捉える光学技術を用いて、ウェーハの欠陥を高速、高感度に検出することが出来る検査装置です。ベアウェーハ、パターン付ウェーハの両方の欠陥検査に対応し、それぞれの欠陥対象に応じて最適な光学系・検出アルゴリズムにより、スピーディ・高感度に欠陥検出を行います。高いスループットにより、従来の抜き取りによる目視検査に代わり、全数検査自動化への推進を実現します。英語サイトはこちら
欠陥検査装置の用途
- Siウェーハ、エピウェーハの最終外観検査
- Siウェーハ製造工程内検査
- ラップ、研削後検査
- ポリッシュ後検査
導入検査工程候補
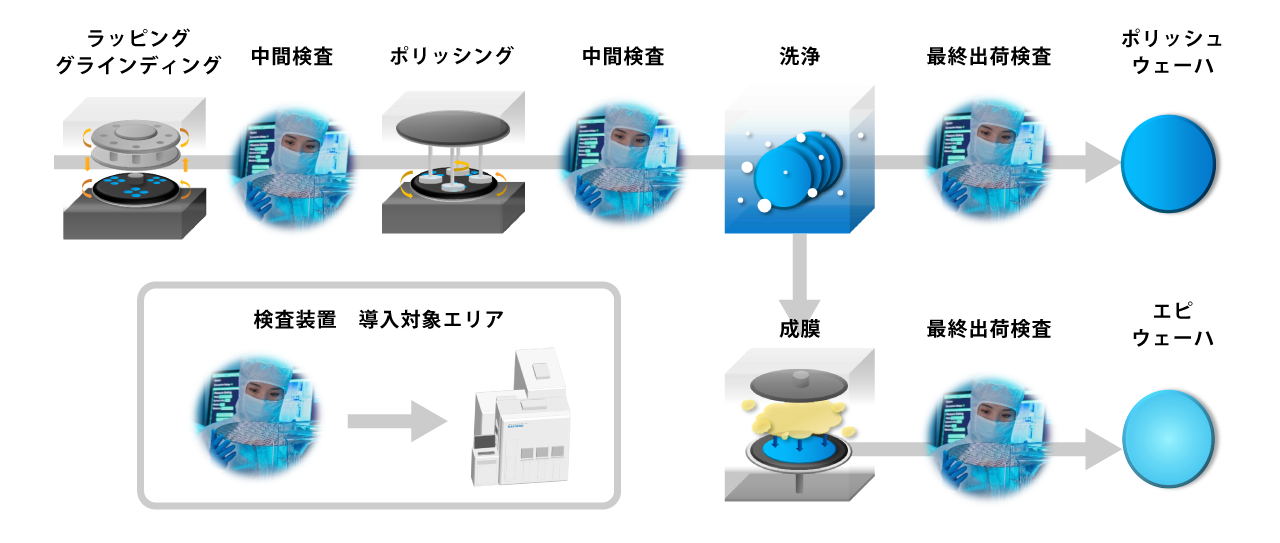
対象の欠陥
- 表面:スクラッチ、クラック、ディンプル、チッピング、突起、 パーティクル、汚れ、色味、研磨痕、研削痕
- エピ面:スリップ、ヘイズ
- 面内:クラック、ピンホール( ドープ濃度:P+, P++)
- 裏面:スクラッチ
- 端面(エッジ):チッピング、クラック、汚れ
特長
高速・高感度検査
専用開発された超低ノイズ光学センサ、専用照明によりウェーハ表面の微小変化を高速・高感度に検出
パーティクルリスク低減
1台で表裏面、端面の欠陥検査を実現できるマルチ検査アーキテクチャーにより、検査時間の削減、装置フットプリントの削減、パーティクルリスクの低減を実現
検査時間の削減
専用統合アプリケーションソフトにより、装置制御・画像取込み・判定までシームレスな検査
トレーサビリティの実現
全てのウェーハ画像、詳細データの記録が残せるため、トレーサビリティを実現
・ウェーハ毎に画像データ、検査詳細情報
・OK品・NG品全てのウェーハ検査結果の履歴
・バーコード、ウェーハID*¹ などの情報を検査データに反映して出力・保存可能
仕様
| 項目 | 詳細 |
|---|---|
| 対応ウェーハサイズ | 200/300mm |
| 対応ウェーハ | Siウェーハ、Siエピウェーハ |
| 検査感度 | 表面:0.3um< ※PSL on Si wafer 端面:1-10μm 面内:1-10μm |
| スループット | 30–90秒 / ウェーハ ※検査要件によって変動 |
| ロードポート・カセット数 | Min2~Max4(12inch) Min2~Max 10(8inch) |
| 他機能 | アライナー、IDリーダー、GEM対応 |
サンプル評価
本検査装置を使用して表面の状態や欠陥部分をご確認したいお客様には、対象となるワークサンプルをお借りし、デモ機による事前評価を行うことが可能です。ご要望の際は、お問い合わせにてお気軽にご相談ください。
 東京エレクトロンデバイス
東京エレクトロンデバイスエンジニアリングセンター
〒224-0045
神奈川県横浜市都筑区東方町17番地
 クリーンルーム
クリーンルーム(Class100)
 RAYSENS LAB
RAYSENS LAB半導体製造現場の課題を解決!厳選ホワイトペーパー
半導体製造現場の「検査」「監視・調査」「セキュリティ」について、例を挙げて解説しています。日々の業務に是非ご活用ください。
半導体は次の次元へ 微細化から集積へ アドバンストパッケージの世界
【この資料で分かること】
- 市場と技術の未来
- アドバンストパッケージの進化
- ウェーハ加工の課題解決
【こんな方におすすめ】
半導体市場やアドバンストパッケージ技術の動向を把握したい方、製造工程やウェーハ加工における課題解決を求めている方、高速化・高密度化を実現する製造技術に興味がある方、次世代半導体の開発に関わる技術者やエンジニアの方

半導体ウェーハの外観検査まるわかりブック
【この資料で分かること】
- 多様なウェーハ材料
- ウェーハ製造工程と外観検査
- 欠陥の種類
- 検査技術のカテゴリ
【こんな方におすすめ】
Siウェーハ、化合物ウェーハ(SiC, GaN, LT/LN, InP), ガラスウェーハ等の検査に関心や課題をお持ちの方

半導体工場の現場DXガイドブック -設備の予知保全、品質監視-
【この資料で分かること】
- 半導体製造工程とDXの取組み
- 製造プロセス監視の作業自動化
- ウェーハ欠陥の原因調査
- 設備稼働監視作業の自動化
- 装置・設備・部品の故障予兆監視
【こんな方におすすめ】
ウェーハ製造工場や、デバイス製造工場のファシリティ設備の業務課題に関心や課題をお持ちの方

OTを止めるな!!半導体業界に必須のサイバー攻撃対策
【この資料で分かること】
- 外部脅威を排除しセキュアな工場へ
- 内部関係者によるリスク対策
- サプライチェーンリスク
- 横感染
- リスク発生&対策ソリューションマップ
【こんな方におすすめ】
半導体製造工場の現場、IT担当者、半導体装置メーカーでセキュリティに関心と課題をお持ちの方

用語集
- フォトルミネッセンス(PL)法
- フォトルミネッセンス(PL)法とは、物質に光を照射し、励起された電子が基底状態に戻る際に発生する光を観測し、得られる発光スペクトルよりさまざまな情報を得ることができます。物質の不純物や欠陥に影響を受けやすいため、この発光を分光し解析をすることで、化合物半導体(SiC、GaNなど)の結晶欠陥を非接触・非破壊で観測することができます。
- コンフォーカル(共焦点)
- コンフォーカル(共焦点)顕微鏡とは、点光源から照射した光を対物レンズでサンプルに焦点を結び、そのサンプルからの反射光あるいは蛍光などを再び同じ対物レンズを通して、光学的に共役な位置に置かれた点検出器上に再結像させる方式による顕微鏡です。従来の顕微鏡よりも鮮明に対象物を観測できるため、半導体のような微細な表面欠陥の形状などの詳しい情報を得ることができます。
- 走査電子顕微鏡(SEM)
- 走査電子顕微鏡(SEM)とは、電子を用いてサンプルの拡大像を観察する装置です。電子は光に比べ波長が短いため、通常の光学顕微鏡に比べて、より小さなものまで見ることができます。数ナノ程度の構造まで観察でき、焦点深度が深い像が得られることから、凹凸の激しい試料表面の構造を拡大して、私達が肉眼で物を見るのと同じような感覚で、三次元的な画像が観察できる装置です。
関連製品・サービス






関連記事










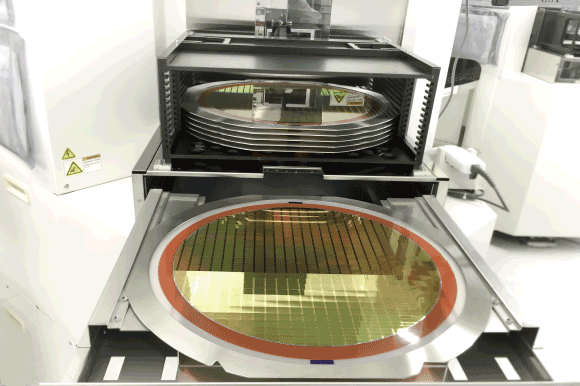
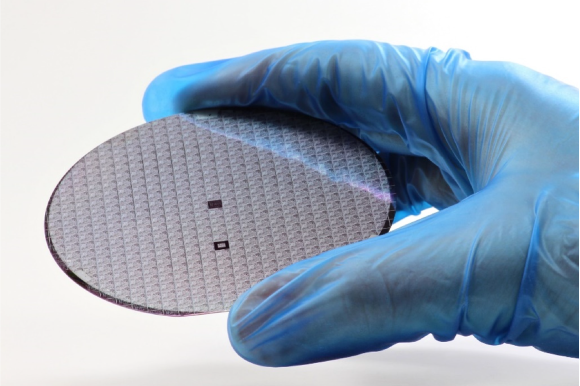
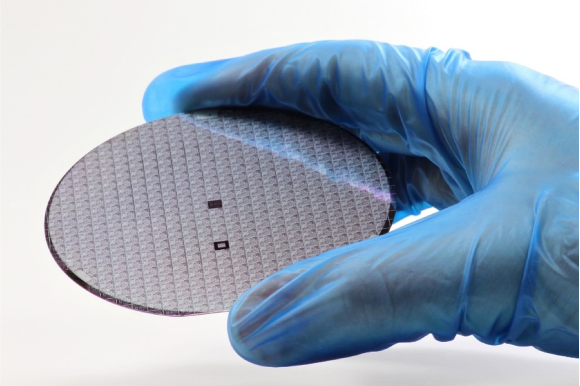













Si ウェーハ 欠陥検査装置


